次世代LEDストリップの設計基準:設置環境と技術選定の要諦
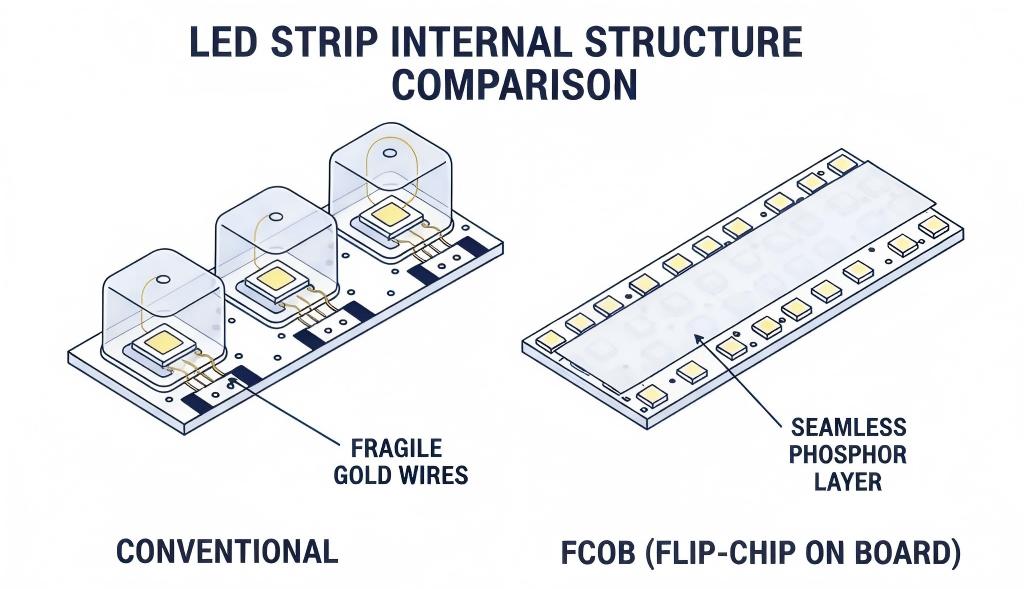
目次
フリップチップ(Flip-Chip)実装技術の概要
SUNSEMIが採用するフリップチップ(Flip-Chip)技術は、従来のワイヤボンディング方式を代替する先進的な実装プロセスです。チップの電極パッドを導電体(はんだペースト等)を介して基板(FPC)にダイレクトに接合することで、物理的・熱的制約を大幅に解消します。
1. 熱物理特性および放熱メカニズムの解析
熱抵抗の最小化: チップと基板が直接接合されているため、熱伝導経路が極めて短く、従来のパッケージ製品と比較して熱抵抗が大幅に低減されます。
熱管理の最適化による動作安定性の向上: 効率的な放熱により、ジャンクション温度(結合部温度)の上昇を抑制。これにより、高出力動作時でもルーメン維持率を高く保ち、LEDの物理的寿命を理論値まで引き出します。
2. FCOB構造における光学的特性の優位性
FCOB (Flip-Chip On Board) 方式: チップ上に蛍光体層を連続形成することで、完全な「ドットレス(点光源の解消)」を実現。配光角が広く、シームレスな線形発光を可能にします。
演色性とスペクトル制御: 高い熱安定性により蛍光体の劣化を抑え、CRI(演色評価数)やR9値の安定した出力を維持します。
3. 機械的信頼性と実装における柔軟性の検証
ワイヤレス構造: 故障の主因となる金線(ワイヤ)を持たないため、物理的な衝撃や熱膨張・収縮による断線リスクを構造的に排除しています。
柔軟な適応性: 内部構造が堅牢であるため、曲げや捻りに対する耐久性が高く、複雑な3D曲面や狭小スペースへの実装において高い信頼性を発揮します。
フリップチップ(Flip-Chip)と従来型(SMD)の比較
LEDテープライトの選定において、パッケージング技術は性能を左右する最も重要な要素です。以下に、SUNSEMIが採用するフリップチップ(Flip-Chip)技術と、従来のワイヤボンディング(SMD)方式の主要な違いをまとめました。
■ テクニカル比較チャート
| 比較項目 | 従来型(SMD/ワイヤボンディング) | フリップチップ(Flip-Chip/FCOB) | 構造的メリット |
| 接続方式 | 金線(ワイヤ)による結線 | 基板へのダイレクト接合 | 断線リスクの排除 |
| 熱抵抗 | 高い(放熱経路が長い) | 極めて低い(最短放熱経路) | 熱劣化の抑制・長寿命化 |
| 最大電流密度 | 低い(熱蓄積による制限) | 高い | 高輝度・高効率の実現 |
| 発光均一性 | 点光源(ドット)が見えやすい | 完全なシームレス(ドットレス) | 光学的質の向上 |
| 機械的柔軟性 | 弱い(曲げによる断線リスク) | 非常に強い | 3D曲面への高い適応性 |
| パッケージサイズ | 比較的大きい | 極小化が可能 | 設計の自由度向上 |
| 信頼性 | 衝撃や振動に弱い | 高耐久(ソリッドステート構造) | 産業用・過酷環境に対応 |
【技術メモ:熱抵抗と寿命の相関】 LEDの寿命はジャンクション温度(結温)に大きく依存します。フリップチップ技術は、熱のボトルネックとなる金線とサブマウントを排除することで、チップからFPC基板への熱伝導率を最大化します。これにより、同じ入力電力でもチップ温度を低く保つことが可能となり、長期的な色度ズレ(Color Shift)を最小限に抑えることができます。
【設計上の注意点:柔軟性の限界】 ワイヤレス構造は物理的な切断に対して強い耐性を持ちますが、FPC基板自体の最小曲げ半径は維持する必要があります。FCOB製品の設計においては、曲げ応力がチップ接合部に直接加わらないような基板パターンの最適化が不可欠です。
